Oxford ICP
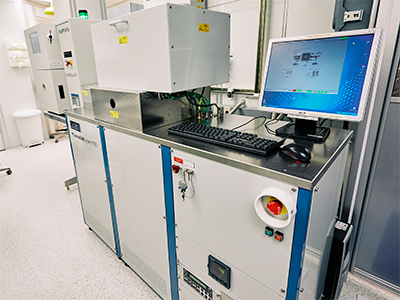
Description
The Oxford Plasma Lab inductively-coupled plasma (ICP) reactive ion etching (RIE) system. The system can etch Si, Si3N4, SiO2, and a variety of metals with good selectivity to standard masking materials. This tool is capable of cryogenic silicon etching, and high aspect ratio deep silicon etching (DRIE/Bosch/DSi, ~5:1).
